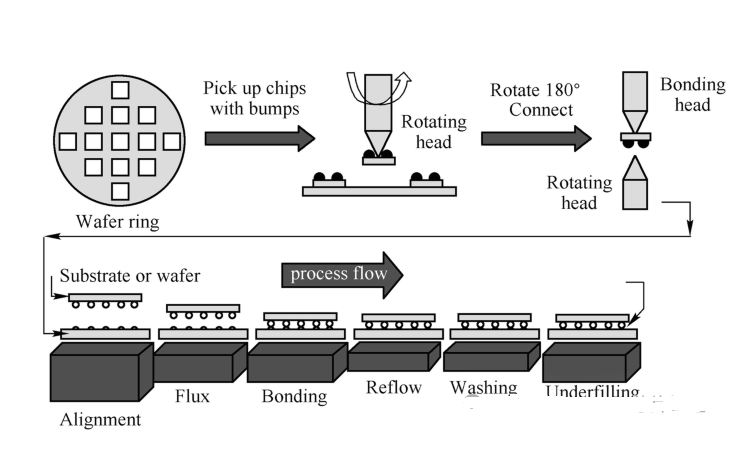
Hayaang magpatuloy ang ’ na matutunan ang proseso tungkol sa paglalagay ng chip.
Gaya ng ipinapakita sa larawan sa pabalat.
1. Mga Pick-up na Chip na may Bumps:
Sa hakbang na ito, ang wafer ay nahati sa mga indibidwal na chip, na idinikit sa isang asul na pelikula o UV film. Kapag ang pagkuha ng mga chips ay kinakailangan, ang mga pin ay umaabot mula sa ibaba, malumanay na itinutulak laban sa likod ng chip, bahagyang itinaas ito. Kasabay nito, tumpak na kinuha ng vacuum nozzle ang chip mula sa itaas, kaya natanggal ang chip mula sa asul na pelikula o UV film.
2. Oryentasyon ng Chip:
Pagkatapos kunin ng vacuum nozzle ang chip, ipapasa ito sa Bonding Head, at sa panahon ng handoff, binago ang oryentasyon ng chip upang ang gilid na may mga bump ay nakaharap pababa, handang ihanay sa substrate.
3. Pag-align ng Chip:
Ang mga bumps ng rotated chip ay eksaktong nakahanay sa mga pad sa packaging substrate. Ang katumpakan ng pagkakahanay ay mahalaga upang matiyak na ang bawat bump ay tumpak na nakaayon sa posisyon ng pad sa substrate. Ang flux ay inilalapat sa mga pad sa substrate, na nagsisilbing linisin, bawasan ang pag-igting sa ibabaw sa mga bolang panghinang, at itaguyod ang daloy ng panghinang.
4. Chip Bonding:
Pagkatapos ng alignment, ang chip ay dahan-dahang inilalagay sa substrate ng Bonding Head, na sinusundan ng paglalapat ng pressure, temperatura, at ultrasonic vibration, na nagiging sanhi ng mga solder ball na tumira sa substrate, ngunit hindi malakas ang paunang bono na ito.
5. Reflow:
Ang mataas na temperatura ng proseso ng reflow na paghihinang ay natutunaw at dumadaloy sa mga bolang panghinang, na lumilikha ng mas mahigpit na pisikal na ugnayan sa pagitan ng mga bukol ng chip at ng mga pad ng substrate. Ang profile ng temperatura para sa reflow soldering ay binubuo ng mga yugto ng preheating, soaking, reflow, at cooling. Habang bumababa ang temperatura, ang mga nilusaw na bolang panghinang ay naninindigan, na makabuluhang nagpapatibay sa ugnayan sa pagitan ng mga bolang panghinang at ng mga substrate pad.
6. Paglalaba:
Pagkatapos makumpleto ang reflow soldering, magkakaroon ng natitirang flux na dumidikit sa mga surface ng chip at substrate. Samakatuwid, ang isang tiyak na ahente ng paglilinis ay kinakailangan upang alisin ang nalalabi ng flux.
7. Underfilling:
Inilalagay ang epoxy resin o katulad na materyal sa puwang sa pagitan ng chip at substrate. Ang epoxy resin ay pangunahing gumaganap bilang isang buffer upang maiwasan ang mga bitak sa mga bumps dahil sa sobrang stress sa kasunod na paggamit.
8. Paghubog:
Pagkatapos magaling ang materyal na encapsulant sa naaangkop na temperatura, isinasagawa ang proseso ng paghuhulma, na sinusundan ng pagsubok sa pagiging maaasahan at iba pang mga inspeksyon, na kumukumpleto sa buong proseso ng chip encapsulation.
Iyon lang ang impormasyon tungkol sa flip chip sa SMT technique. Kung gusto mong matuto pa, kumuha lang ng order sa amin.

 Pilipino
Pilipino English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba